【微型光谱仪应用】微型光谱仪在半导体膜厚检测中的应用
一、背景
晶圆膜厚测量技术始于20世纪70年代,早期采用接触式方法,但精度低且易损伤晶圆。80年代后,非接触式技术兴起,实现微米级无损检测并提升效率。随着半导体工艺节点缩小至纳米级,光谱仪等设备逐步普及,可同步分析膜厚与光学参数,满足亚纳米级精度需求。
二、应用概述
光纤光谱仪通过垂直入射光在薄膜上下表面反射产生干涉,利用反射光谱中的干涉峰位置变化,结合数学模型计算膜厚。其采用宽光谱或单波长光源,适用于透明/半透明材料,具有非接触、高精度及无损检测优势。该方法广泛应用于半导体制造与光学镀膜领域,支持实时在线监测与多层膜分析。
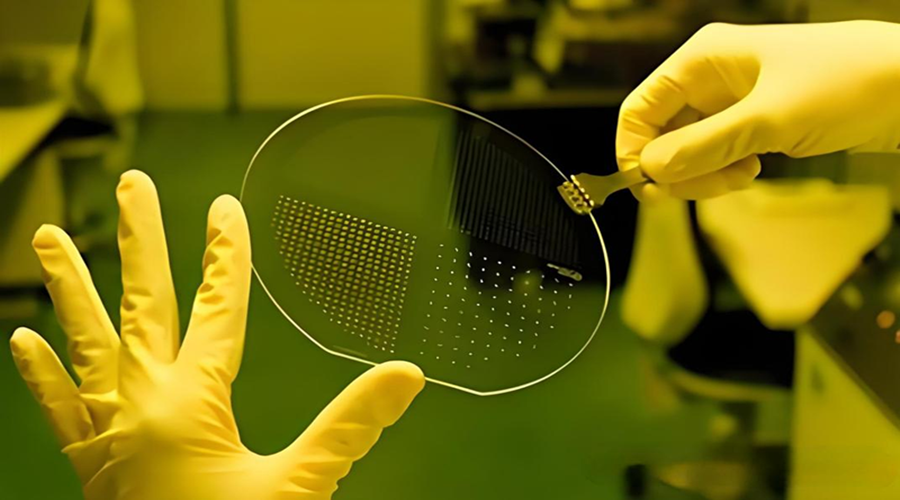
图1:晶圆镀膜
三、技术原理
如何使用光纤光谱仪测薄膜厚度?

图2:原理
上图为采用光纤光谱仪测膜厚的原理图,光束以θ1入射到薄膜表面,一部分直接反射,另一部分则以θ2 发生折射,折射光经膜层下表面反射后再经其上表面发生折射,反射光1与反射光2相干发生干涉。使用光纤光谱仪测量薄膜的厚度主要是基于其反射干涉光谱。
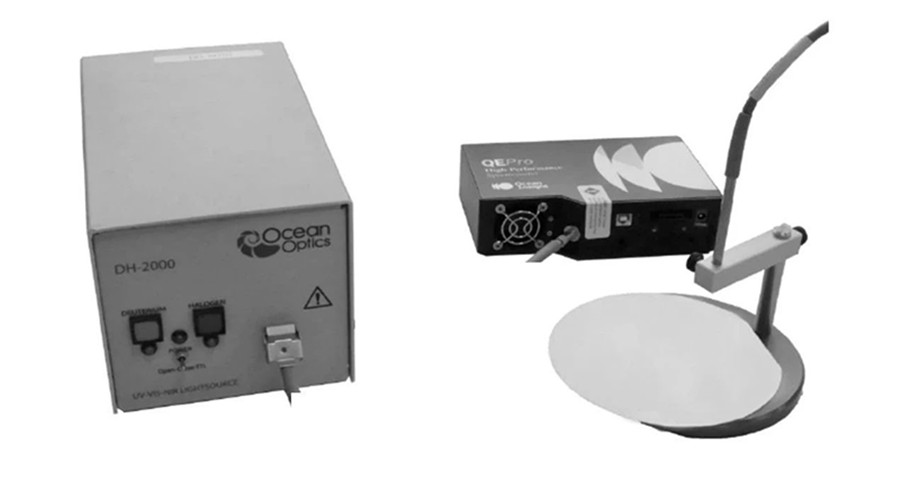
图3:实物
测量时,整个光路主要由反射探头组成,探头部分垂直于晶圆向下放置,光纤端一部分连接光源,形成入射光,另一部分连接光纤光谱仪,接收反射光谱。反射光谱曲线中干涉峰的出现是薄膜干涉的结果。在薄膜干涉实验中,波长与介质折射率、薄膜厚度之间有如下关系:

白光干涉法测反射光谱时,由于我们采取垂直入射得方法( θ10, θ20),因此上式可简化成:

如果知道具体k的值,就可根据干涉峰位推算出膜层厚度d,但由于每个干涉波峰和波谷所对应的k很难确定,且不同厚度的薄膜k值都不相同,因此通常采用消去k的方法求出薄膜的厚度d。

图4:不同厚度薄膜的反射光谱
假定反射光谱曲线上有相邻的两个波峰λ1与波谷λ2,可联立两式求得薄膜的厚度d。

实际上, 从反射光谱上可以得到多组波峰和波谷对应的波长, 计算出多个薄膜厚度的数值, 然后求平均以减少测量误差。
四、实验装置
典型配置如下:
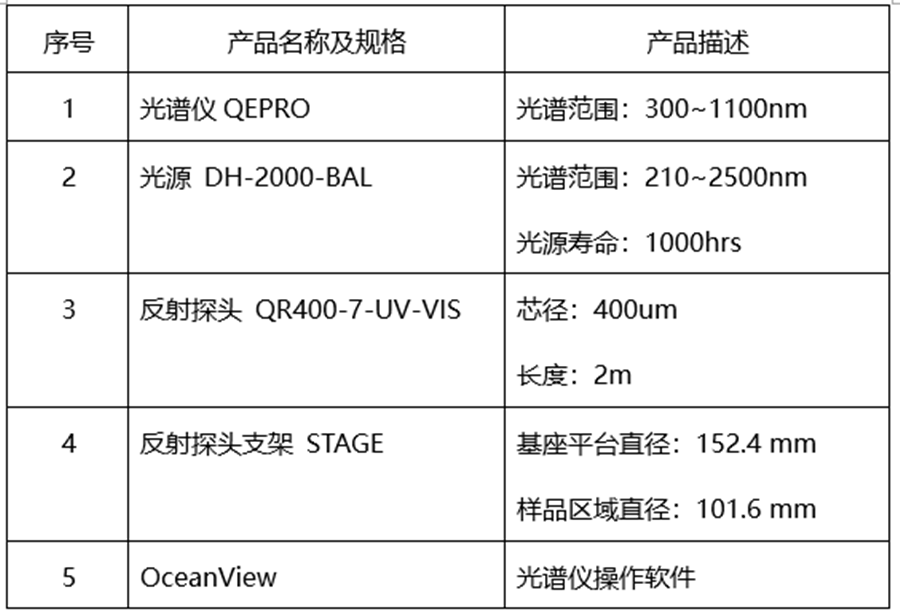
五、结语
光纤光谱仪通过分析垂直入射光在薄膜上下表面反射形成的干涉光谱,结合数学建模实现纳米级膜厚测量,其非接触式光学设计避免了样品损伤并支持透明/半透明材料检测。该技术采用宽光谱或单波长光源适配不同材料特性,结合高速采样(毫秒级)与便携式结构(USB即插即用),可满足工业流水线实时在线监测需求,同时通过干涉信号解耦算法实现多层膜结构的精准分析,在半导体制造、光学镀膜等领域推动高精度标准化质量控制。


 沪公网安备 31010602003785号
沪公网安备 31010602003785号